Quelques nouvelles du 10 et 7nm chez TSMC
TSMC tenait la semaine dernière à San José son symposium, une conférence au cours de laquelle le fondeur taiwanais a partagé des détails inédits sur ses prochains process de fabrication de puces. Des détails rapportés par nos confrères d'EETimes et de Semiwiki (partie 1 et partie 2 ).
16FF+ et 16FFC
Pour le 16nm, si Apple l'utilise depuis de longs mois, les autres clients semblent peiner à lancer leur production, probablement à cause des coûts importants engendrés par la nouvelle technologie et aussi de quelques limites de capacité. TSMC s'est contenté de confirmer que son 16FF+ est en production "volume" (c'est à dire dédiée à des produits finis) depuis le troisième trimestre 2015 et qu'il s'attend à ce que son volume de wafers 16nm augmente significativement entre juin et octobre avec pour but d'atteindre 300 000 wafers par trimestre d'ici à la fin de l'année. Plusieurs produits 16FF+ sont déjà en production, comme les FPGA de Xilinx.
En parallèle TSMC propose également une version "compacte" (16FFC) de son process qui tente de réduire les coûts en diminuant par exemple le nombre de masques nécessaires. Cette version FFC sera celle qui sera privilégiée pour les usages non haut de gamme, même si elle propose plusieurs avantages intéressants, par exemple pour les usages très basse consommation (tension d'alimentation de 0.5V), mais aussi pour une version spécifique aux usages automobiles (une variante qui attendra mi 2017). TSMC avait annoncé cette variante publiquement en janvier, mais la production en volume sera entamée dès le mois d'avril. 70 tapeout 16FFC sont attendus cette année (à titre de comparaison, il y a déjà eu 70 tapeout 16FF+ en 2016), il sera intéressant de voir quels produits l'utiliseront !
10nm
TSMC est confiant sur l'arrivée du 10nm, même s'il s'agira vraisemblablement d'un node qui ne sera pas utilisé par tout le monde. La production en volume prendra place dans la Fab 15, dans deux nouvelles tranches construites pour l'occasion (les autres tranches produisent en 28nm). Le constructeur s'attend à produire 200 000 wafers par trimestres d'ici la fin de l'année 2017. Un premier tapeout 10nm pour un produit d'un de ses clients aurait été réalisé et la qualification est attendue au troisième trimestre cette année.
Malgré tout le 10nm reste un node qui sera limité côté clients, Xilinx ayant par exemple indiqué publiquement qu'ils attendraient le 7nm. Étant donné les délais suspicieusement courts entre le 10 et le 7nm, on peut les comprendre (productions en volume respectives annoncées pour 2017 et 2018) !
7nm
L'attente autour du 7nm est importante, et TSMC a commencé a donner quelques réponses à nos interrogations. D'abord, le fondeur proposera dès le début deux versions distinctes de son process 7nm, une version dédiée au mobile, et une autre aux produits hautes performances (+10 à 15% de performances en plus, avec pour but d'atteindre 4 GHz).
Les deux variantes devraient entrer en qualification en simultané au premier trimestre 2017. Pour expliquer le délai court entre le 10 et le 7nm, nous avions spéculé que le constructeur utiliserait une stratégie identique à celle utilisée entre le 20 et le 16nm, à savoir utiliser un BEOL (la partie basse de la puce qui contient les couches métalliques d'interconnexion) commun ce qui limiterait les gains de densité.
Après avoir évité a plusieurs reprises de répondre à la question dans ses conférences aux investisseurs, TSMC a confirmé que ce ne sera pas le cas : la variante mobile du 7nm apportera une densité 1.63x supérieure à celle de son 10nm ! C'est certes moins que le passage 28 à 20nm (1.9x) mais largement au dessus de la transition 20 à 16nm (1.15x, obtenu principalement par des optimisations des règles de design). Par rapport au 10nm, le 7nm devrait apporter 15 à 20% de performances en plus, ou 35 à 40% de consommation en moins selon les usages.
TSMC utilisera un matériel commun à 95% entre le 10 et le 7, facilitant la transition. La différence tiendra sur l'utilisation plus massive à 7nm du quadruple patterning (on ne sait pas encore exactement ou il sera utilisé, il semblait entendu sur les dernières roadmaps ITRS que le quadruple patterning - SAQP - serait utilisé pour les couches métal à 10 et 7 par exemple).
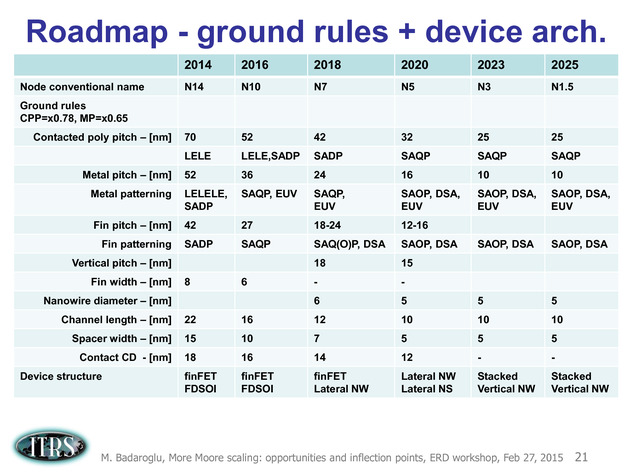
Le développement du 7nm avance puisque TSMC a indiqué avoir déjà produit des modules de SRAM de 128 Mbit, atteignant déjà des yields de 30% pour des dies pleinement fonctionnels. Il est toujours difficile de comparer ces chiffres tant les constructeurs les gardent secrets. En février 2010, soit une vingtaine de mois avant le lancement des premiers GPU 28HP (les Radeon 7970), TSMC annonçait cependant des yields sur sa SRAM de 26% . Atteindre 30% sur des puces pleinement fonctionnelles semble donc particulièrement encourageant à ce stade.
Si l'on considère les difficultés attendues par tous à 10 et à 7nm, la roadmap de TSMC semble particulièrement agressive et il faudra voir si le fondeur arrive a l'exécuter. On comprendra en tout cas qu'il ne faudra pas s'attendre à voir de 10nm ailleurs que chez Apple, ou possiblement Qualcomm étant donné les délais.
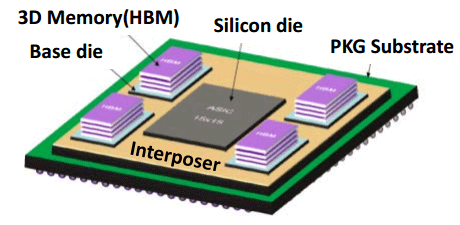
On conclura sur quelques informations données côté packaging, TSMC pense que c'est de ce côté que l'on réalisera des gains "faciles" et importants. D'abord pour la version haute performance CoWoS (Chip on Wafer on Substrate) qui consiste à utiliser un interposer en silicium pour relier des puces, le fondeur indique que l'on pourra atteindre des tailles plus importantes à 7nm dépassant les 1200mm2 (l'interposer utilisé par AMD sur les Fury X mesure un peu plus de 1000mm2) ce qui devrait donner un peu plus de marge. TSMC a également indiqué avoir réalisé le tapeout le mois dernier d'un "CPU" accompagné de deux piles de mémoire HBM2.
Côté mobile, c'est l'InFO WLP (Integrated FanOut Wafer Level Packaging) qui devrait apporter des gains intéressants. Par rapport au CoWoS, il s'agit d'une version beaucoup plus fine qui réduit voir élimine le substrat en "moulant" un ou plusieurs dies pour reconstituer un package très fin. TSMC annonce 20% de performances en plus pour une consommation 10% inférieure.
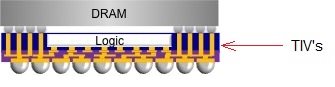
Exemple d'InFO POP
TSMC a rajouté une variante POP qui ajoute la possibilité de superposer un autre package (par exemple mémoire) par dessus un package InFO. TSMC utilise des fils dans les parties neutres du die pour relier la puce du dessus (des TIV, un concept identique aux TSV - through silicon Vias - si ce n'est que les fils traversent cette fois ci le package InFO et non un interposer). La production des InFO POP devrait débuter au second trimestre, ce qui coïncide côté timing avec le début de production attendu du prochain SoC d'Apple qui devrait utiliser ces technologies de packaging.
Contenus relatifs
- [+] 27/04: Le 10nm d'Intel (encore) retardé, l...
- [+] 27/04: AMD Vega 7nm en labo, Zen 2 échanti...
- [+] 08/03: GlobalFoundries : 12nm, 7nm et EUV
- [+] 30/01: TSMC confiant sur l'EUV en volume p...
- [+] 30/01: L'activité d'Intel poussée par le s...
- [+] 09/01: CES: Silence sur l'après Pascal che...
- [+] 29/11: Samsung lance la production en volu...
- [+] 19/10: Samsung annonce la qualification de...
- [+] 21/09: AMD utilisera le 12nm de GloFo en 2...
- [+] 11/09: Un nouveau 14nm chez Samsung



