1 Go DDR3 TSV pour Elpida
Elpida a commencé à livrer les échantillons d'une mémoire de 1 Go DDR3 utilisant la technologie TSV (Through Silicon Via). Cette technologie permet de relier plusieurs die entre eux via des connexions verticales qui passent donc au travers même des die. Cette verticalité permet de réduire drastiquement la longueur des connexions, ce qui permet entre autre d'améliorer la vitesse, d'abaisser la consommation et de réduire la taille du packaging. Attention, si certains parlent de "Puces 3D" pour cette technologie, elle n'est pas à confondre avec les transistors Tri-Gate ou "3D" mis au point notamment par Intel.
La puce de 1 Go DDR3 TSV mise au point par Elpida combine 4 die 256 Mo capables de fonctionner en DDR3-1600 à 1.5v et en 1333/1066 à 1.35v. L'utilisation de deux puces de ce type en lieu et place d'une barrette SO-DIMM de 2 Go classique permet selon Elpida d'abaisser de 50% la consommation en charge et 20% la consommation au repos. Elpida suggère d'ailleurs que ceci peut permettre de se passer de SO-DIMM pour intégrer la mémoire directement sur le PCB, mais ceci se fait alors au dépends des possibilités de mises à jour.
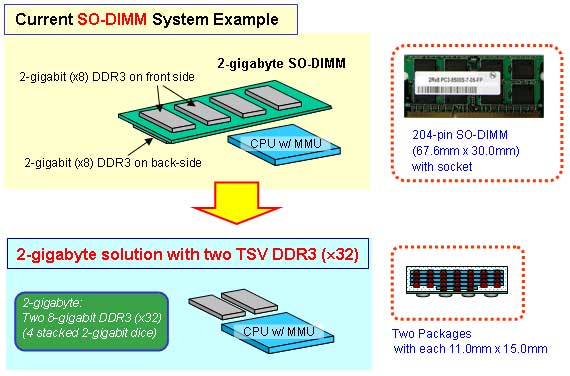
Elpida travaille sur la technologie TSV depuis 2004, et avait annoncé en 2009 être le premier à avoir développé une puce mémoire DDR3 de 1 Go. Après le stade du développement, Elpida passe donc désormais à l'échantillonnage sur cette nouvelle puce, mais n'indique pas de date pour la disponibilité en volume.
Le fabricant n'est toutefois pas le seul sur cette technologie et tous les fondeurs travaillent dessus. Samsung a par exemple annoncé en décembre dernier avoir développé une barrette RDIMM de 8 Go à base de puces mémoire DDR3 40nm TSV qui était jusqu'à 40% plus économe qu'une barrette RDIMM conventionnelle. Samsung précisait alors que la technologie TSV devrait commencer à se democratiser à partir de 2012.
Contenus relatifs
- [+] 11/01: CES: La GDDR5M victime des déboires...
- [+] 31/07: Micron et Elpida, c'est fait
- [+] 22/03: Des pertes pour Micron, malgré la h...
- [+] 24/12: Micron toujours dans le rouge
- [+] 03/07: Micron croque Elpida, et devient n°...
- [+] 09/05: Micron sur le point d'acquérir Elpi...
- [+] 28/02: Elpida annonce sa banqueroute, la D...
- [+] 25/01: Prototype de ReRAM chez Elpida
- [+] 24/01: Elpida, Nanya et Micron ?
- [+] 22/12: Rapprochement Elpida-Nanya ?



